:no_upscale():quality(80)/https%3A%2F%2Fimg.4gamers.com.tw%2Fckfinder%2Ffiles%2FElvis%2FNews%2F2021-07%2FIntel%2FIntel-Accelerated-2021-presentation-11.jpg)
Intel 揭曉截至 2025 年的最新製程與封裝技術發展藍圖,不僅導入全新的製程節點命名方式,同步發表全新的電晶體架構 RibbonFET 和業界首款背部供電方案 PowerVia。

Intel 向來以閘極長度當作製程節點的命名方式,但隨著 Intel Foundry Services(晶圓代工服務)成立,未來將以製程節點的每瓦效能為基準,導入全新命名方式,也讓客戶更易於識別。
Intel 製程節點技術演進
| 製程節點名稱 | 10nm SuperFin | Intel 7 | Intel 4 | Intel 3 | Intel 20A | Intel 18A |
| 理念/目標 | - | 原名強化版 10nm SuperFin | 原名 7nm | 供電、面積效率強化 | 進入 Å 時代 | 未定 |
| 每瓦效能強化 | - | 10-15% | 20% | 18% | 未定 | 未定 |
| 可用性 | 已大量生產 | 進入量產階段 | 2022 下半年投產 2023 上半年出貨 |
2023 下半年投產 | 2024 上半年投產 | 2025 投產 |
| 產品 | Tiger Lake | 消費級:Alder Lake 資料中心:Sapphire Rapids |
消費級:Meteor Lake 資料中心:Granite Rapids |
未定 | 未定 | 未定 |


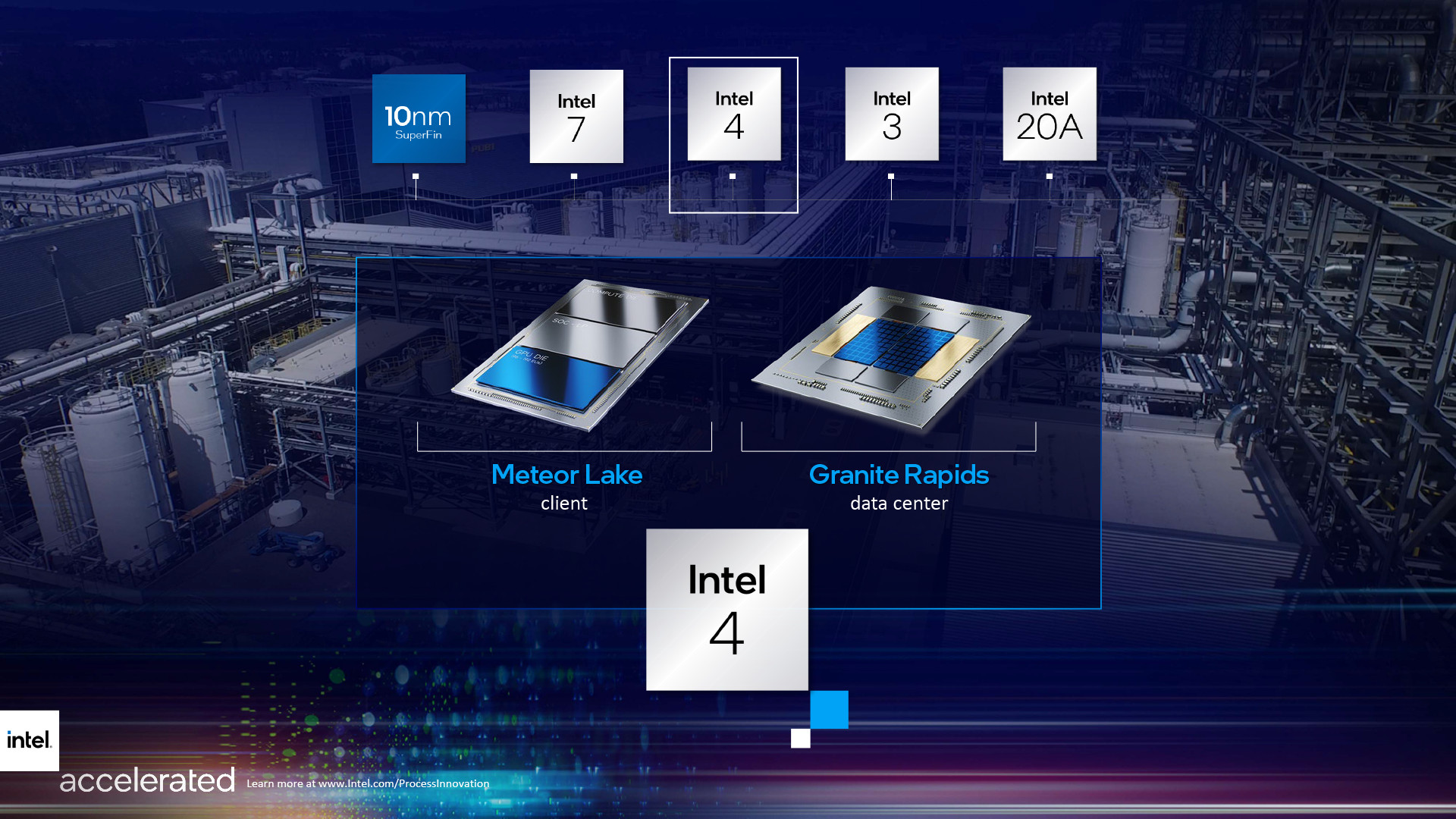
Intel 7 原名「強化版 10nm SuperFin」,持續將 FinFET(鰭式場效電晶體)最佳化,相較 Intel 10nm SuperFin 的每瓦效能可提升大約10% ~ 15%。率先應用於今(2021)年登場的客戶端(消費級)產品 Alder Lake ,以及 2022 年第一季量產的資料中心產品 Sapphire Rapids 。
Intel 4 原稱 7nm,全面使用極紫外光(EUV)微影技術,透過超短波長的光,印製極小的形狀。相較 Intel 7 每瓦效能可提升約 20%,以及面積改進。預計在 2022 下半年準備量產,2023 上半年開始出貨,消費級的 Meteor Lake 和資料中心的 Granite Rapids 將率先採用。
Intel 3 進一步汲取 FinFET 最佳化優勢與提升EUV使用比例,以及更多的面積改進。相較 Intel 4 每瓦效能可提升約 18%,預計在 2023 下半年準備開始生產。
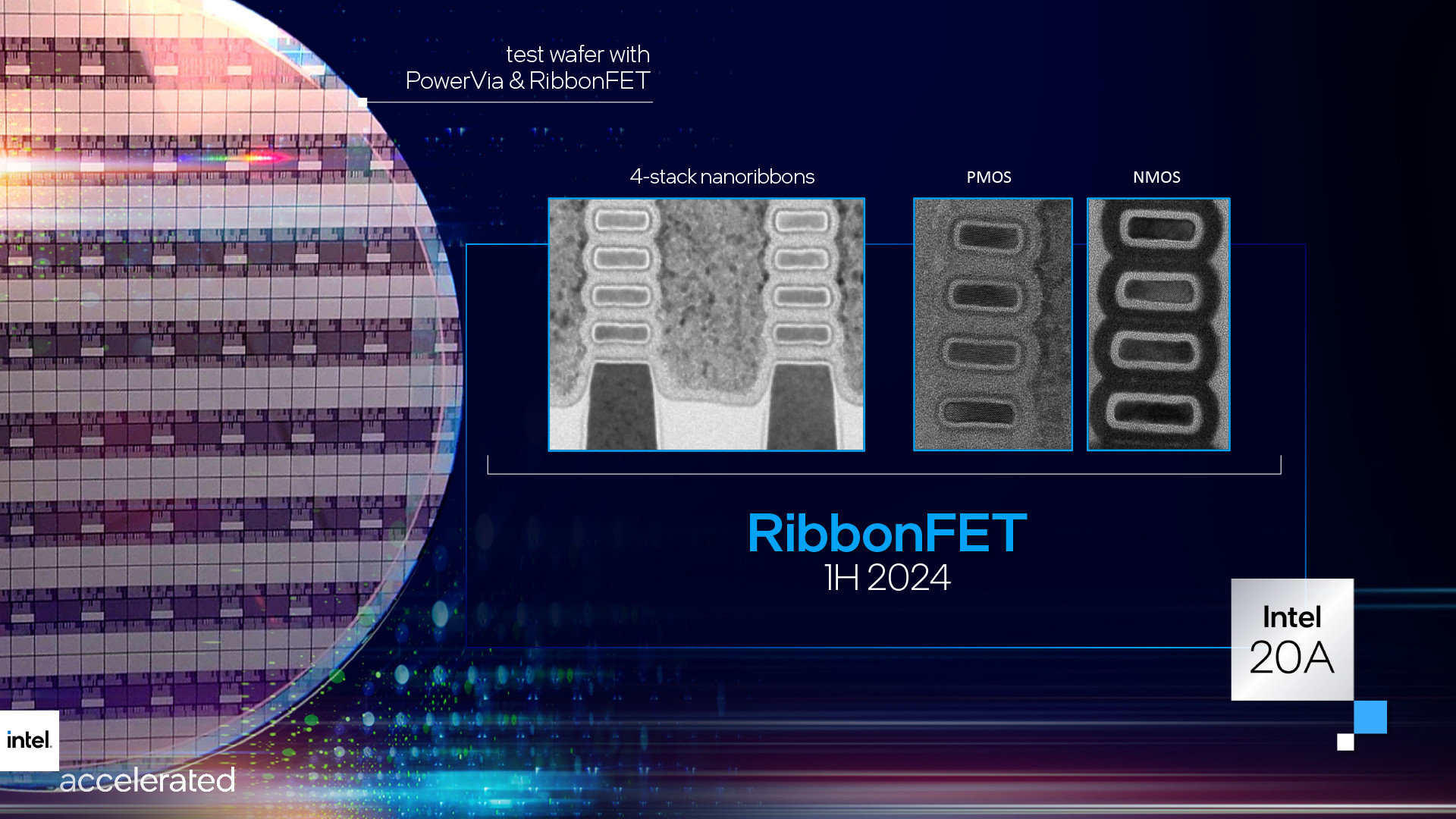




Intel 20A 以 和 PowerVia 這兩項突破性技術開創埃(Å,angstrom,1 Å = 10nm)時代。預計於 2024 年逐步量產,Qualcomm 同時宣布將採用 Intel 20A 製程技術。
RibbonFET 為英特爾環繞式閘極(Gate All Around)電晶體的實作成果,同時也是自 2011 年推出 FinFET 後,首次全新電晶體架構。該技術可於於較小的面積當中堆疊多個鰭片,於相同的驅動電流提供更快的電晶體開關速度。
PowerVia 為英特爾獨家且業界首次實作的背部供電,藉由將晶圓正面供電所需迴路轉移到背面,進一步最佳化訊號傳遞效率。
Intel 18A 已進入開發階段,持續改良 RibbonFET,預計於 2025 年初問世,將為電晶體帶來另一次的重大性能提升。
Intel 也正在定義、建立與佈署次世代 EUV 工具,稱之為「高數值孔徑 EUV」,同時與 ASML 緊密合作,可望獲得業界首套量產工具,確保這項業界突破技術能夠成功超越當代 EUV。
Intel 最新封裝技術發展藍圖
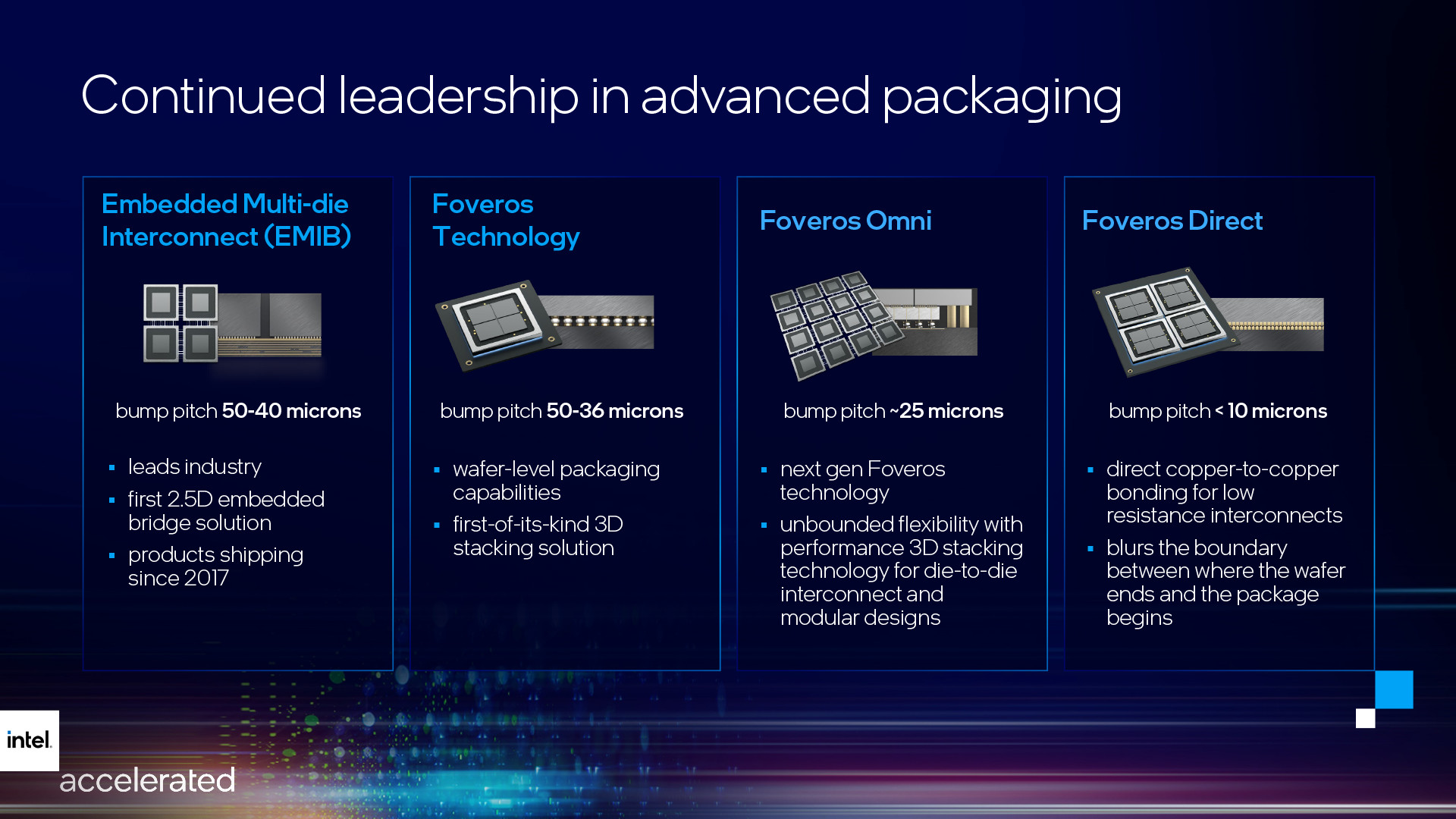



EMIB (Embedded Multi-die Interconnect Bridge) 為 2.5D 嵌入式橋接解決方案,Sapphire Rapids 將是首款量產出貨的 Intel Xeon 資料中心產品,同時也是業界首款具備 4 個方塊晶片的裝置,提供等同於單一晶片設計的效能。Sapphire Rapids 之後,次世代的 EMIB 將從 55µm(微米)凸點間距降至 45µm。
Foveros 為 3D 堆疊解決方案,Meteor Lake 將是 Foveros 在消費級產品實作的第二世代,具備 36µm 凸點間距,晶片塊橫跨多種製程節點,TDP 橫跨 5W ~ 125W。而 Ponte Vecchio GPU 將會融合 EMIB 和第二代 Foveros 兩種封裝技術。
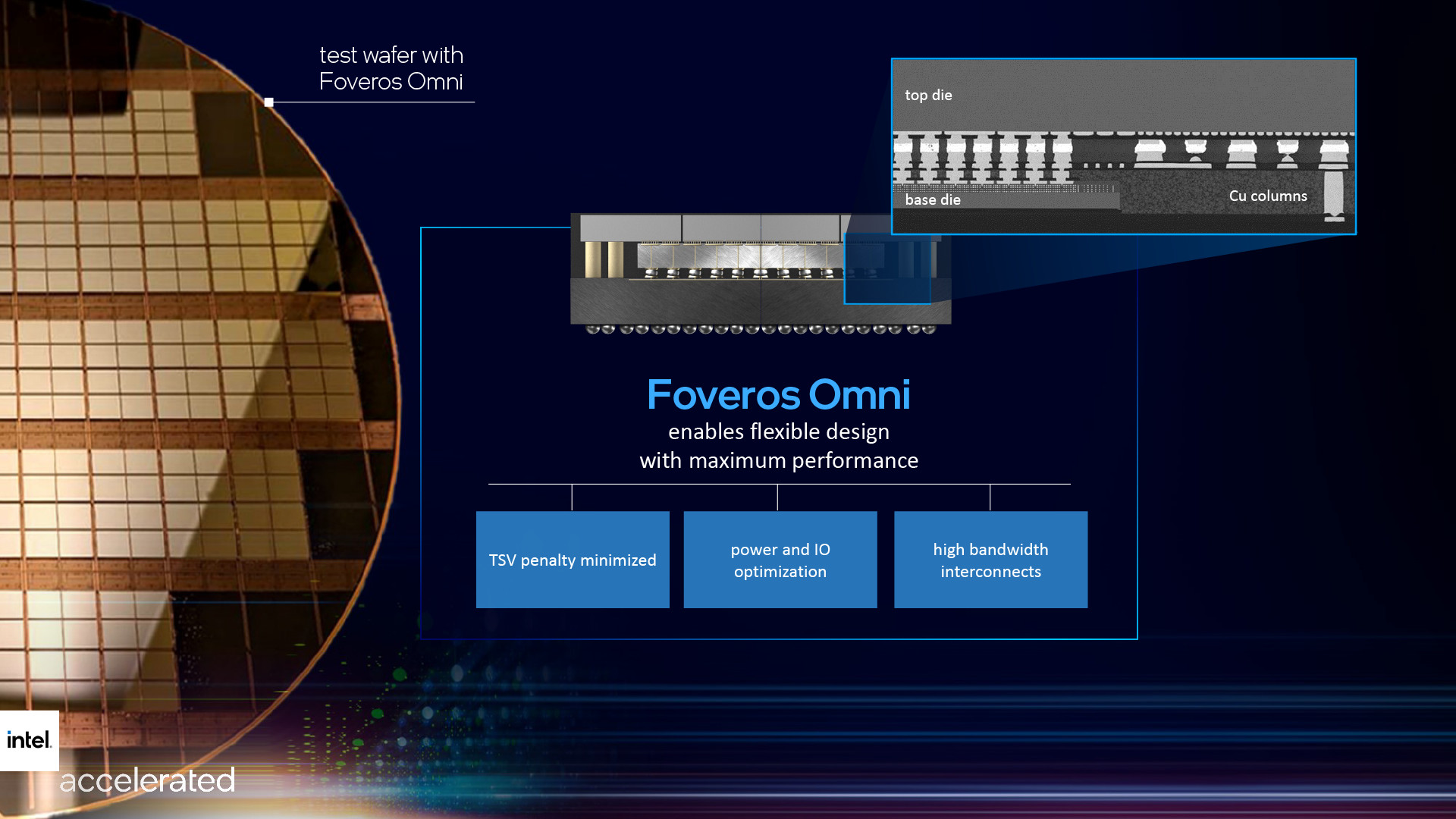
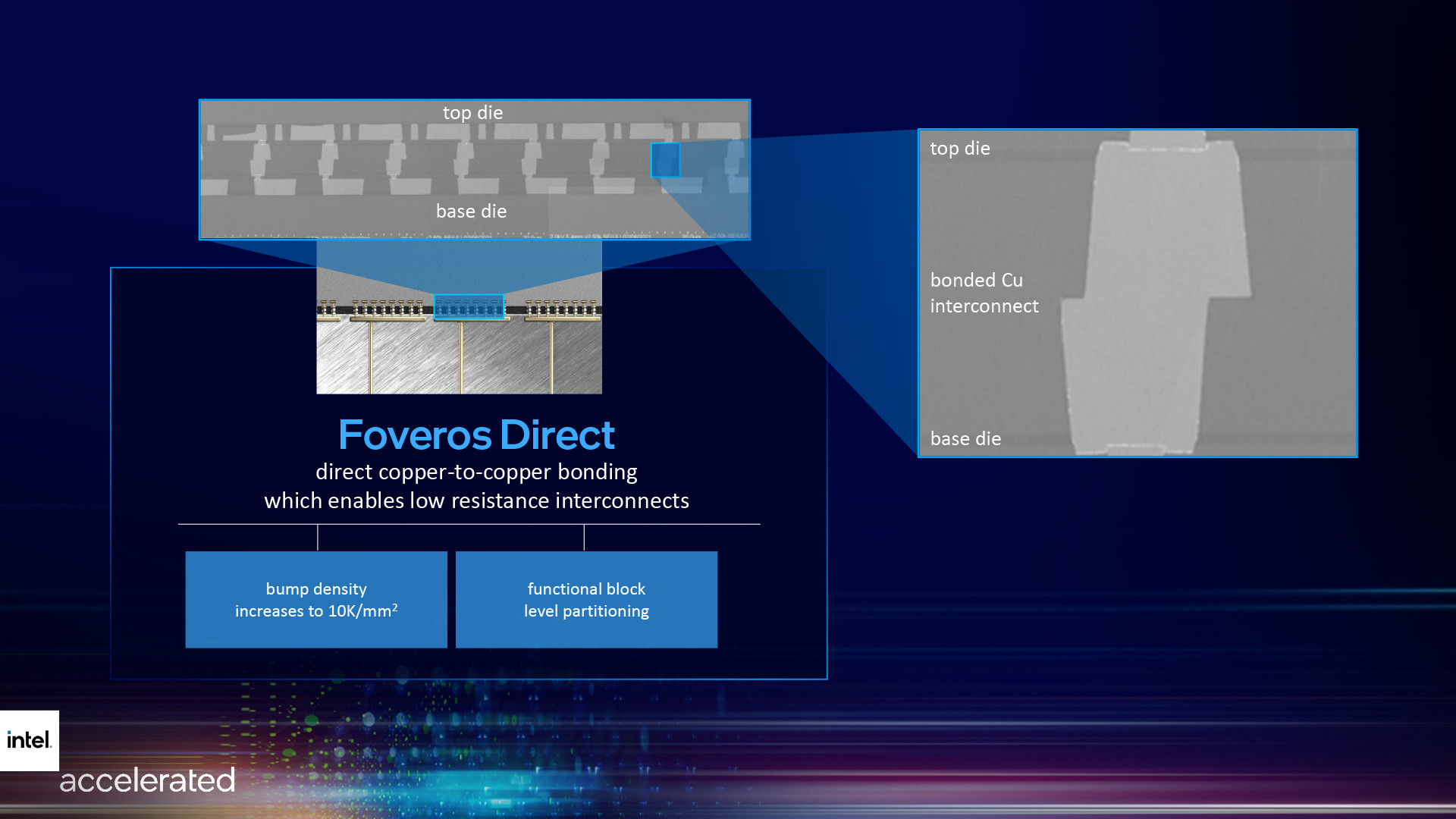
Foveros Omni 採用晶片與晶片連結與模組化設計,提供不受限的靈活高效能 3D 堆疊技術,允許混合多個頂層晶片塊與多個基底晶片塊,以及橫跨多種晶圓廠節點的分拆晶片(die disaggregation)設計,預計於 2023 年準備大量生產。
Foveros Direct 是 Foveros Omni 的補充技術,為降低互連電阻,改採直接銅對銅接合技術,模糊了晶圓製造終點與封裝起點的界線。Foveros Direct 能夠達成低於 10µm 的凸點間距,提升 3D 堆疊一個量級的互連密度,為原先被認為無法達成的功能性晶片分割開啟新頁,預計於 2023 年問世。





