:no_upscale():quality(80)/https%3A%2F%2Fimg.4gamers.com.tw%2Fckfinder%2Ffiles%2FElvis%2FNews%2F2021-07%2FIntel%2FIntel-Accelerated-2021-presentation-16.jpg)
Intel 日前於美國夏威夷檀香山舉行的 VLSI(Very Large Scale Integration,超大型積體電路) 2022 IEEE 研討會中公布 Intel 4 製程的技術細節。
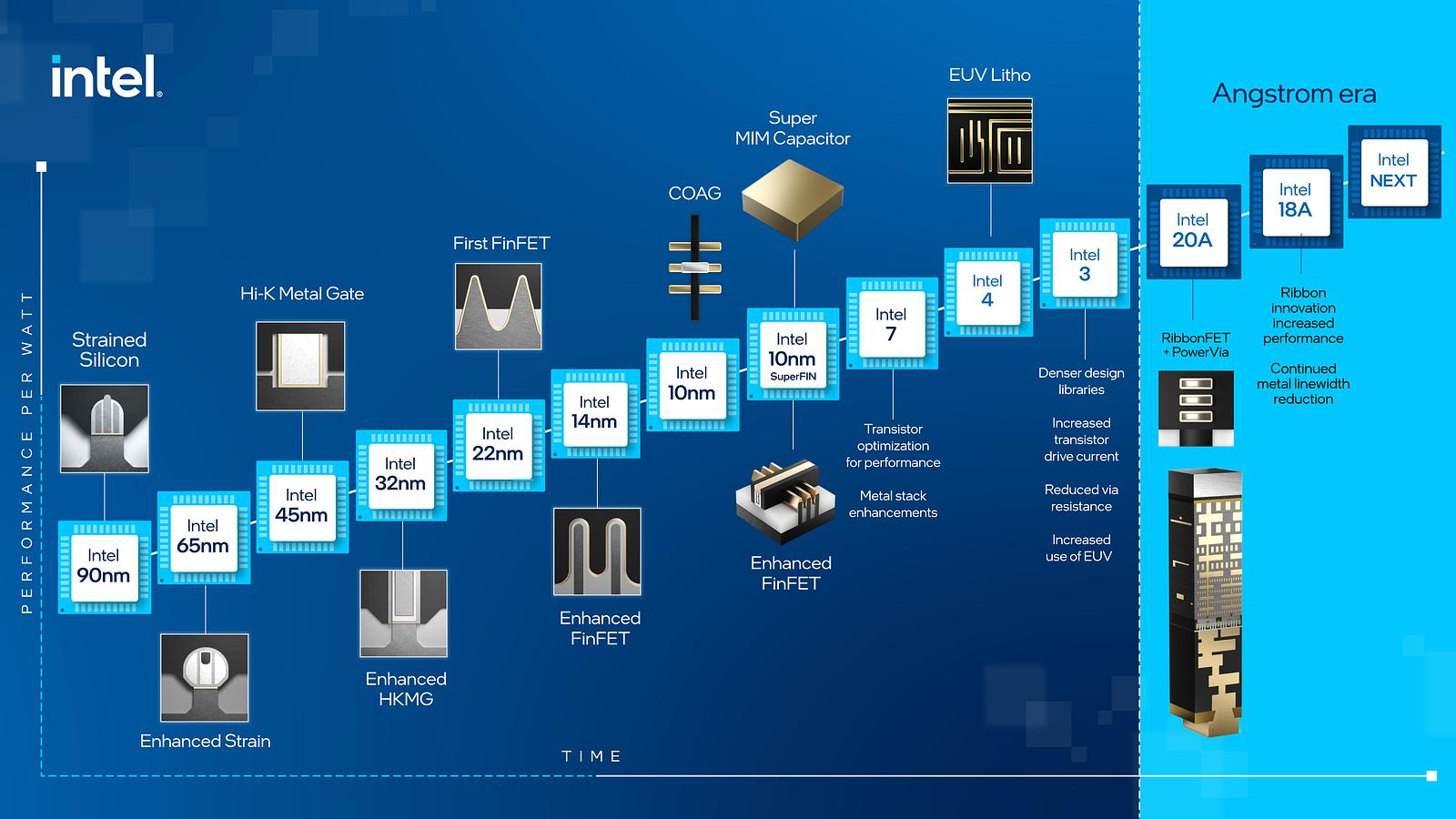
相較於現行 Intel 7(原名強化版 10nm SuperFin) 製程,Intel 4(原為 7nm)製程在相同功耗的效能可提升 20% 以上,高效能元件庫(Library Cell)密度則可增至 2 倍,預計應用於 2023 年上市的 Meteor Lake 平台(第 14 代 Intel Core 處理器)。
Intel 指出,Intel 4 於鰭片間距、接點間距以及低層金屬間距等關鍵尺寸(Critical Dimension),持續朝向微縮的方向前行,並同時導入設計技術偕同最佳化,縮小單一元件的尺寸。
而透過 FinFET 材料與結構上的改良提升效能,Intel 4 的單一 N 型半導體或是 P 型半導體,其鰭片數量從 Intel 7 高效能元件庫的 4 片降低至 3 片。綜合上述技術,使得 Intel 4 能夠大幅增加邏輯元件密度,並縮減路徑延遲和降低功耗。
延續 Intel 7 已導入的自對準四重成像技術(Self-Aligned Quad Patterning、SAQP)和主動元件閘極上接點(Contact Over Active Gate、COAG),不僅透過單次微影和兩次沉積、蝕刻步驟,將晶圓上的微影圖案縮小 4 倍,免除多次微影層疊對準的問題,還在閘極上方做出閘極接點,進而提升元件密度。
Intel 4 更進一步加入網格布線方案(gridded layout scheme),簡單化並規律化電路布線,提升效能同時並改善生產良率。
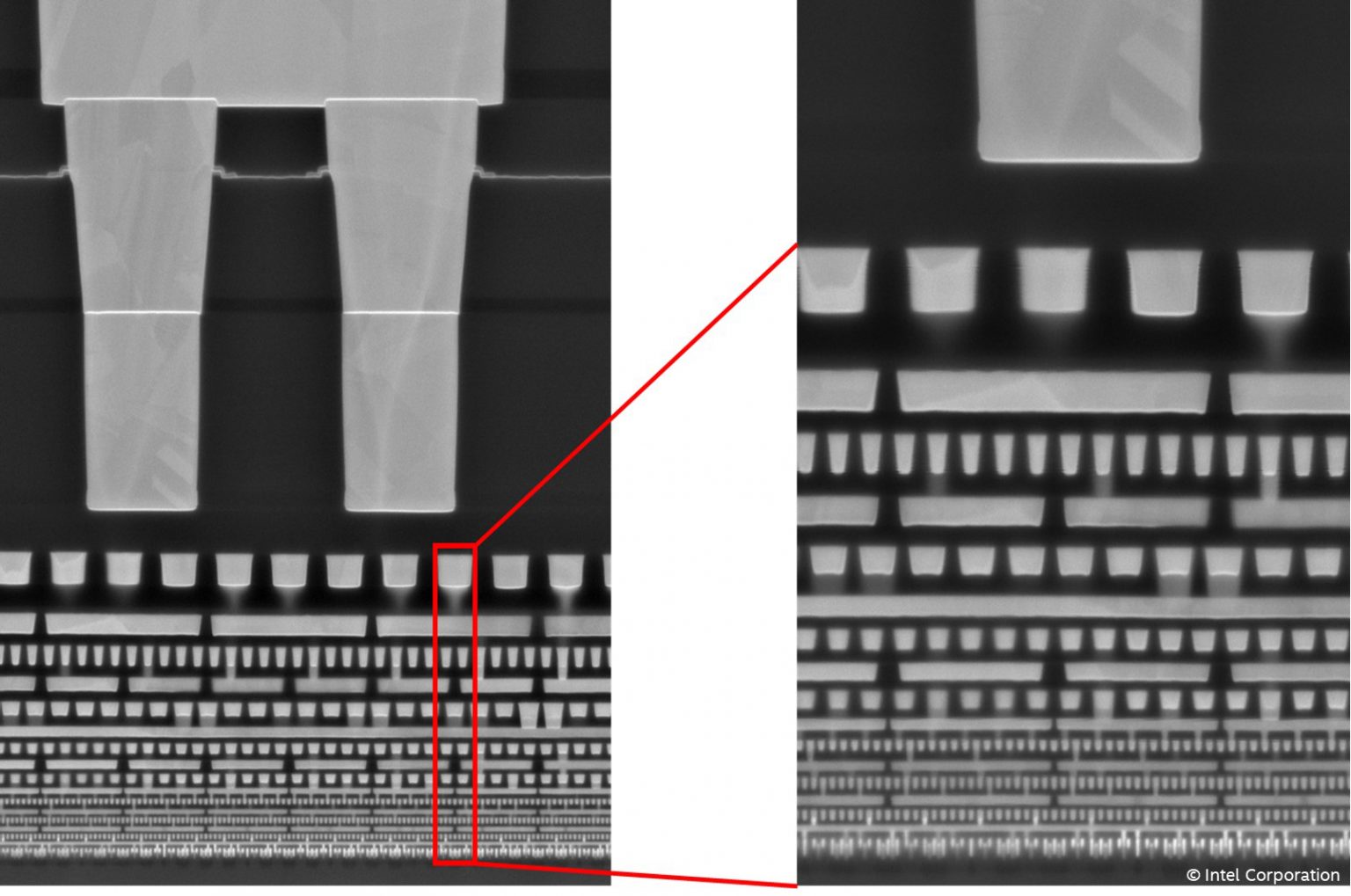
隨著製程微縮,電晶體上方的金屬導線、接點也隨之縮小。其中導線的電阻和線路直徑呈現反比,該如何維持導線效能是需要克服的重要課題。
Intel 4 引進全新名為強化銅(Enhanced Cu)的金屬配方,使用銅做為導線、接點的主體,取代Intel 7 所使用的鈷,外層再以用鈷、鉭包覆。此配方不只獲得銅的低電阻特性,還能降低自由電子移動時撞擊原子使其移位,進而讓電路失效的電遷移(electromigration)現象。該技術可延續應用至 Intel 3 和未來的製程。
Intel 不僅在現有良好解決方案中的最關鍵層使用 EUV,更在 Intel 4 的較高互連層中使用 EUV,以大幅減少光罩數量和製程步驟和複雜性。Intel 將更廣泛地使用 EUV,並導入全球第一款量產型高數值孔徑(High-NA)EUV 系統,替未來製程節點建立技術領先地位及設備產能。
Intel 希望藉由這些新技術,於 2025 年重掌製程領先地位,我們就拭目以待吧!





