:no_upscale():quality(80)/https%3A%2F%2Fimg.4gamers.com.tw%2Fpuku-clone-version%2F92df73fe89b9014fa34c650ef46a49d8b1217983.jpg)
AMD 在 CES 2025 上發表了代號 Strix Halo 的 Ryzen AI MAX 300 系列高性能行動處理器,有著最高 16 核、32 執行緒的 CPU,外加 40 組 CU 的巨型 GPU。而在看不到的規格之外,AMD 使用新的方案來連接 CCD 小晶片,改善傳輸延遲。
外媒 Chips and Cheese 訪問了 AMD 高級晶片研究工程師 Mahesh Subramony,與大家分享關於 Ryzen AI MAX 300 處理器系列在開發與設計上的幕後故事。
Ryzen AI MAX 300 使用 Zen 5 架構,也同樣採用 Chiplet 小晶片設計,其中裝載 CPU 核心的晶片被稱為 CCD,每顆 CCD 能夠擠入 8 顆核心,因此在 Ryzen AI MAX+ 395、AI MAX 390 這種核心數量超過 8 組的產品上,資料運算有時就會出現跨 CCD 傳輸的情況。
然而長久以來 AMD 在跨 CCD 運算上,都被詬病延遲太高,這是因為 CCD 的連接方案,包含現在最新的 Ryzen 9000 桌上型系列,均是採用 SERDES (Serializer / Deserializer,串行器 / 解碼器) 方案,好處是能夠容許更長傳輸路徑,但缺點就是加重延遲。
不過在 Ryzen AI 300 上,AMD 將連接方式改用「線路海」(Sea of wire)策略,使用大量電路直接連接每顆小晶片,取代原有的 SERDES 設計,線路支援每時脈週期 32 bytes 的資料吞吐量,且因為少了額外轉換的步驟,讓 CCD 之間傳輸更具效率,延遲也就跟著降低。
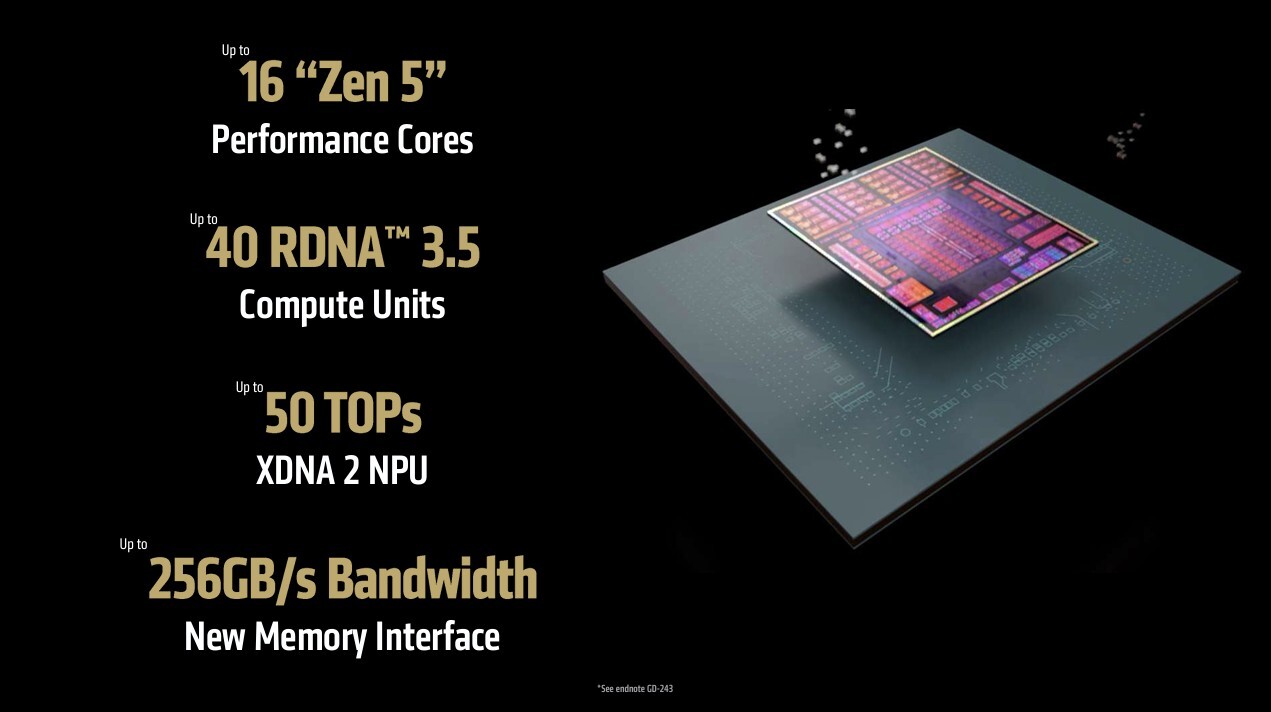

當然,新的連接設計不是沒有缺點,首先它的製造成本更高,甚至比 Ryzen 9950X3D 的連接方案還要貴,且需要更高密度的主機板引角,造成 PCB 版在設計上變得更複雜,好在 Ryzen AI MAX 300 系列是行動版產品,處理器都是預先鑲嵌好之後再賣給消費者,所以不構成的太大的影響
此外從 Mahesh Subramony 的分享,棄用 SERDES 會讓傳輸線路縮短,使得 Ryzen AI MAX 300 處理器系列的小晶片需要全數緊靠在一起,不再像過去一樣分的那麼開,這對發熱多少會帶來影響,可能也是為何方案會優先用在具功耗限制的行動平台上。

綜合上述的問題,若希望新的 CCD 連接方案來到桌上型平台,至少主機板的處理器腳位將可能需要重新設計,恰巧 AMD 過去曾經承諾 AM5 腳位至少支援到 2025 年,換言之,下一代 Ryzen 處理器會是設計大改的新契機。





