
處理器晶片生產除了製程是一大難關外,封裝方式所需考量的問題也不少,近期 Intel 發表了新的封裝方案,主要針頓改善處理器最上層用於保護與協助均勻散熱的 IHS 散熱蓋,透過強化平整度與貼合的度方式,有望讓處理器尺寸進一步加大。
晶片產品由於十分脆弱,會在外層加上 IHS 散熱蓋來進行保護,然而因為產品定位、架構、製程設計的不同,形狀與設計都會不同,為了讓 IHS 散熱蓋能夠與晶片緊密貼合,以確保熱量能夠正常導出,傳統上散熱蓋會使用高精度的沖壓與 CNC 切割技術。
這些方式在小尺寸上問題還不大,但到了像是 Intel Xeon、AMD EPYC 等工業級大尺寸處理器時,散熱蓋因為覆蓋面本身凹凸不平的關係,導致存在彎曲以及大量公差空隙,對於這些超高功耗的產品,反而對貼合度與散熱帶來不利影響,成為處理器想要增加尺寸上的一道難題。
對此 Intel 構思了出了新的方案,概念上與傳統方案顛倒過來,不是讓立體造型散熱蓋去配合晶片布局,而是透過在晶片四周加入支撐面(Stiffeners),再讓一塊「全平面」的金屬蓋進行覆蓋,如此一來就解決過去立體造型 IHS 散熱蓋因紋路分布不均而翹起彎曲的問題。
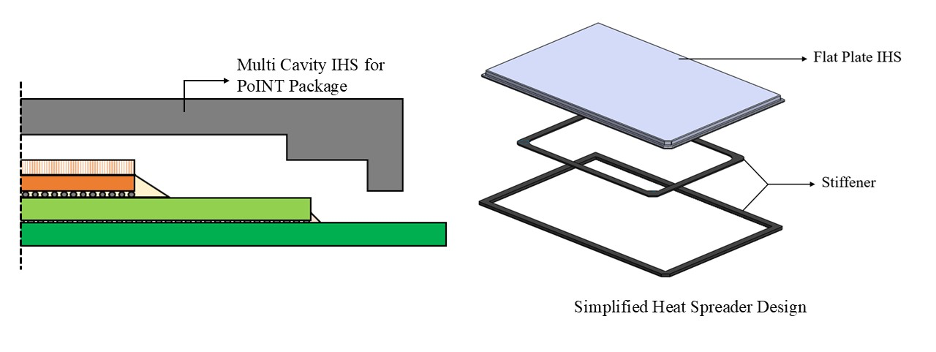
不過此時可能有人就會問了,一顆處理器上有好幾種晶片,每個晶片現實高度又不同,全平面的薄片不是會讓必較矮的晶片無法貼合嗎?
這部分 Intel 沒有給出太詳細地說明,但根據設計圖,原理上是讓支撐架依照晶片需求,被設計成好幾種高度,讓較矮的晶片可以圍出一個面,再用更為先進的導熱介質進行填充,配合散熱蓋整體更穩固的貼合性,彌補了無法直觸的缺憾。講得知直白點,就好比先灌水泥再舖地板。
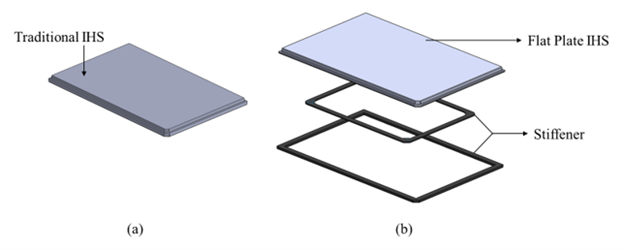
Intel 表示,透過此方式,IHS 散熱蓋的平整度提升了 7%,封裝過程產生的彎曲減少 30%,且貼合空隙大幅減少了 25%,讓原本會阻擋散熱的空隙獲得改善,讓整體的散熱效率獲得提升,評估後認為有機會促成更大尺寸處理器的誕生。

最後,Intel 的工程師們也在探索如何將這種方法進一步應用於其他專用散熱解決方案,例如高導熱金屬複合散熱器以及與液冷系統的整合,為不斷突破上限的晶片功耗帶來新的可能,滿足未來的運算產品的需求。





